適用於先進半導體製造的隨機性(stochastics)微影圖案誤差量測與控制解決方案領導業者Fractilia今天宣布Fractilia Automation Metrology Environment(FAME™)產品組合推出最新生力軍:FAME 300。專為量產(HVM)晶圓廠製造環境所設計的FAME 300,可針對先進節點之微影圖案化誤差最大來源隨機效應(stochastics effects),提供即時測量、檢測與監控。透過FAME 300,晶圓廠可以在數分鐘內找出由隨機變異所引起的潛在製程問題,並進而採取快速的校正動作,提升微影圖案化製程的管控並進而優化良率。 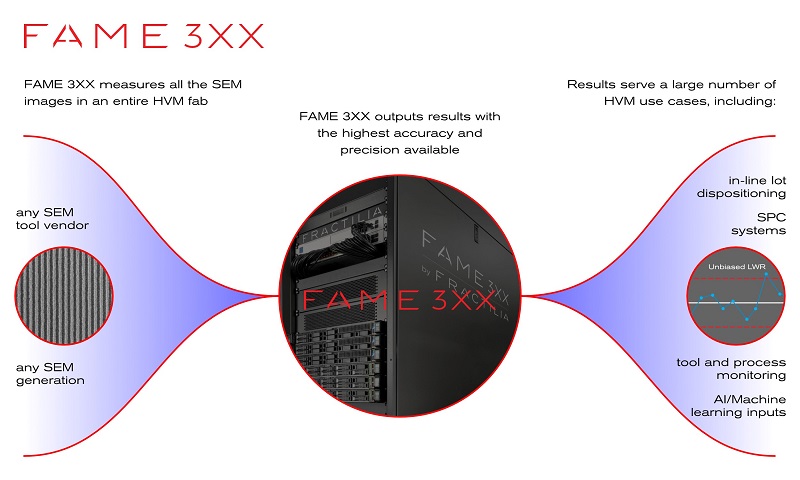
圖1:專為量產晶圓廠製造環境設計FAME 300,提供即時測量、檢測與監控。透過FAME 300,HVM晶圓廠可在數分鐘內找出由隨機變異引起的潛在製程問題,提升及優化EUV圖案微影圖案化製程與良率(圖/Fractilia)
FAME 300可以針對各種隨機效應與臨界尺寸(CD)量測,運用FILM™專利技術,提供準確與精密測量的晶圓廠解決方案。Fractilia的產品皆已通過半導體先進製程研發測試使用,以及半導體製造商、設備商與材料供應商製程的開發環境考驗。所有以Fractilia產品產生的測量數值,都可以從研發轉移至量產,並可以完全自動化。
Fractilia技術長Chris Mack博士表示:「先進技術的晶圓廠目前正遭遇顯著增加的隨機變異挑戰,隨著半導體產業嘗試以持續擴充的規模推進摩爾定律,這種情況只會越來越糟。為了控制隨機性誤差,我們必須對它進行準確量測;如此一來,全新的晶圓廠製程才能進一步提高良率。我們將FILM量測引擎和專為高通量、高可靠性與低延遲打造的全新FAME 300平台進行整合,目前已經可以把我們的隨機性誤差測量能力導入晶圓廠的量產環境,使我們的客戶得以更好地管控他們的量產製程,且由於產品不用再承受隨機性誤差的風險,甚至有可能省下好幾個月的時間。」 
圖2:隨機性誤差在先進製程上是個日益嚴重的良率難題。在EUV製程中,微影製程圖案錯誤的製程容錯空間,可能超過一半都耗費在隨機性誤差上(圖/Fractilia)
全新的FAME 300平台利用基於Kubernetes叢集且具備高度擴充性的架構,能夠測量晶圓廠全廠所有掃描式電子顯微鏡(SEM)影像所需的通量。FAME 300可保證讓晶圓廠在幾分鐘內取得操作資料,並提供其前饋或回饋的製程控制。FAME 300的應用範圍包括在線任務與量產監控的關鍵應用場景,以及批量處置(lot dispositioning)、即時偏移檢測、邊緣圖案置放誤差優化、微影與蝕刻製程工具監控、SEM設備健康監控、SEM跨機台及跨供應商設備之匹配、蝕刻工具腔體匹配等其它場景。Fractilia針對量產純監控的應用外,並提供額外的工具配置,給予客戶更高的價值。
「精準去除量測雜訊」的量測值能為晶圓製造變異提供完整全貌 Fractilia的FAME解決方案產品組合使用專有且獨特、符合物理定律的SEM演算模型與資料分析方法,可從SEM影像量測並修正量測機台上隨機與系統性的雜訊,提供晶圓微影圖案(on-wafer)上實際的量測值,而非影像上(on-image)參雜量測機台雜訊的圖案量測值。FAME平台可同時量測所有主要的隨機效應,包括線邊粗糙度(LER)、線寬粗糙度(LWR)、局部線寬均勻度(LCDU)、局部邊緣圖案置放誤差(LEPE)、隨機缺陷偵測及其他效應。FAME平台提供業界最佳訊號對訊噪的邊緣偏移檢測,訊噪比相較於其它解決方案高出5倍,且每張SEM影像可以擷取出超過30倍的特徵資料。
此外,FAME平台適用於所有的SEM設備供應商及跨世代不同機型,並可以讓SEM的設備間匹配度提升5到20倍,同時讓SEM產能提升超過30%。客戶不但可以在同一世代與型式的SEM工具上達成史無前例的匹配效能,更可以在不同世代、甚至在不同SEM設備供應商之間辦到。
Fractilia執行長暨總裁Edward Charrier表示:「Fractilia的FILM技術是業界公認的製程隨機性誤差量測標準。到目前為止,領先業界的半導體元件製造商、大型設備製造商、材料供應商、研究聯盟與其它單位的研發機構,有超過1,000家的用戶使用我們的FILM產品,並在光學接近修正(OPC)、微影、蝕刻、沉積、量測與檢驗、材料與其它製程中,累積許多經實證考驗的應用場景。客戶使用我們的產品所量測到的SEM影像數量,每年都會增加一倍以上。半導體業界顯然需要將Fractilia開發的精準隨機性誤差量測技術應用於量產。現在,我們全新推出的FAME 300系統能夠協助我們的客戶,實現更準確、更紮實地管控他們的量產微影圖案化製程。」 
圖3:FAME 300平台利用基於Kubernetes叢集及高擴充性架構,能測量晶圓廠全廠所有掃描式電子顯微鏡影像所需通量,可保證讓晶圓廠在幾分鐘內取得操作資料,並提供其前饋或回饋的製程控制(圖/Fractilia)
Fractilia出席SPIE先進微影+微影圖案化大會 Fractilia將於下週加州聖荷西市聖荷西會議中心舉行的SPIE先進微影+微影圖案化大會上,將針對隨機性誤差的量測與控制解決方案效益提出多項報告。 |